HOME > Products >
Electronic material > Low flow bonding sheet > AD-7006W/AD-7006
Low resin flow |
AD-7006W / AD-7006

|
| ▲AD-7006W (Left) and AD-7006 (Clear type) |
Features
- Low resin flow at applying process.
- Excellent in handleability at applying process.
- Excellent in Bonding strength.
- Excellent in flexurability after thermosetting.
|
Low resin flow property (Test results) |
The below photos show that resin flow at Cu lamination peocess were within 50μm. |
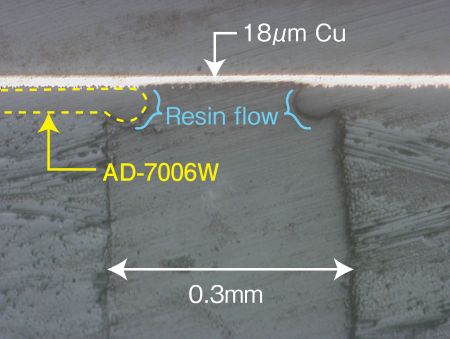 |
【Test image】
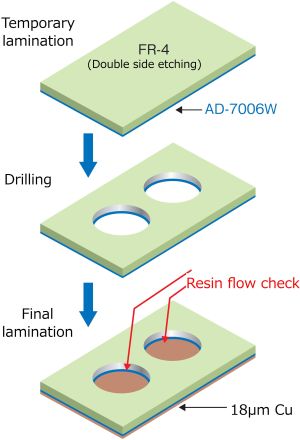
①Double side etched FR-4 substrate was temporarily laminated with AD-7006W
②The above substrate was drilled
③Finally the substrate was laminated with 18μm Cu and cross section of the drilled holes were checked with SEM (Scanning Electron Microscope). |
|
▲Cross section of 0.3mmφ
|
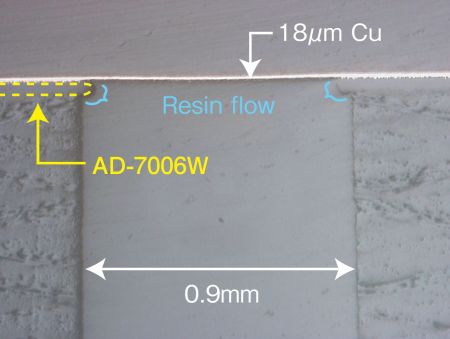 |
▲Cross section of 0.9mmφ
|
Material composition |
 |
【Thickness of insulation layer】
| AD-7006W |
:40μm |
| AD-7006 |
:40μm |
|
Melt viscosity |
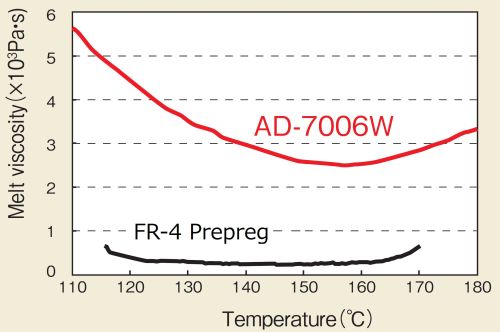
|
General properties of insulating layer |
| Test item |
Unit |
Treatment |
AD-7006W
AD-7006 |
| Thickness |
μm |
- |
40 |
| Halogen free compliance |
- |
- |
◯ |
| Peel strength |
kN/m |
18μm |
1.8 |
| Solder limit |
sec |
260℃
Float |
300< |
| Volume resistivity |
MΩm |
C-96/20/65 |
9.5×107 |
| Surface resistance |
MΩ |
C-96/20/65 |
1.0×109 |
| Dielectric constant (1MHz) |
- |
C-96/20/65 |
2.8 |
| Dissipation factor (1MHz) |
- |
C-96/20/65 |
0.031
(1.0mm thick.) |
| Glass transition temperature(TMA) |
℃ |
A |
124 |
| Coeficient of thermal expansion |
ppm/℃ |
α1 |
48 |
| α2 |
358 |
| Water absorption |
% |
E-24/50
+D24/23 |
1.9 |
| Poisson's ratio |
- |
A |
0.42 |
Thermal conductivity
(Hot wire method) |
W/mK |
A |
0.3 |
| Low resin flow property |
- |
- |
◯ |
| Handleability |
- |
- |
◎ |
| Anti-discoloration property |
- |
- |
△ |
|
| The various above-mentioned data is measured value, and is not guaranteed performance. |
Propoasal of application of RISHO thermal solution materials

Click the above picture for more information
|
| |